尔必达试产新工艺的DDR3内存颗粒
日本尔必达今天宣布,已经开始试验性出货业内第一款采用TSV硅穿孔(又称硅通孔)堆叠工艺制造的DDR3 SDRAM内存颗粒。TSV全称为Through Silicon Via,是一种新型三维堆叠封装技术,主要是将多颗芯片(或者晶圆)垂直堆叠在一起,然后在内部打孔、导通并填充金属,实现多层芯片之间的电连接。
相比于传统的引线连接多芯片封装方式,TSV能够大大减少半导体设计中的引线使用量,降低工艺复杂度,从而提升速度、降低功耗、缩小体积,也是IBM、Intel等行业巨头竞相追逐的新技术。
尔必达从2004年开始从事TSV技术的研发,并获得了日本政府发起的新能源与产业技术开发组织(NEDO)的资助。2009年,尔必达成功开发了业内第一款TSV DRAM芯片,使用八颗1Gb DDR3 SDRAM堆叠封装而来。
尔必达此番推出的样品是一种低功耗的8Gb DDR3 SDRAM内存颗粒,使用TSV技术将四颗2Gb DDR3 SDRAM封装在一块芯片内而来,1.5V电压下频率可达1600MHz,1.35V低电压下则是1066/1333MHz。
尔必达称,这种新型颗粒用在SO-DIMM笔记本内存条上,能够降低20%的读写功耗和50%的待机功耗,而且还非常环保。
对于一条2GB容量的笔记本内存来说,使用传统颗粒需要八颗芯片,换上TSV工艺的则仅需两颗,芯片所占空间会因此大幅减少70%,自然有利于打造更轻薄的笔记本、平板机产品。
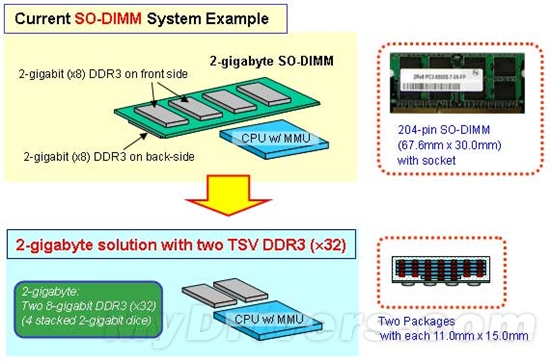
评论 {{userinfo.comments}}
-
{{child.nickname}}
{{child.create_time}}{{child.content}}






{{question.question}}
提交
昨夜今晨:苹果或将推迟iPhone Air 2发布 华为申请 “齐界” 商标
昨夜今晨:工信部通报39款APP涉违规侵权 刘嘉玲喊话淘宝天猫维权
iPhone17系列大卖!中国市场销量超900万台
Meta被曝通过违规广告牟利百亿,平台治理遭质疑
驱动号 更多